基于Hypermesh的Flip-Chip封装工艺对电子器件的可靠性研究
2019-04-18 by:CAE仿真在线 来源:互联网
Flip-Chip封装具有成本低、工艺简单、引脚密度高和可靠性高等优点,目前已成为高端高密度IC封装中的主流封装形式。Flip Chip封装中,在回流焊之后,需要对Chip、Solder、Substrate部位进行灌胶处理。然而,由于回流焊后会在Solder周围残留助焊剂等杂质缺陷,Solder表面不能完全充满Underfill。本文,对清洗干净条件下的Solder充满Underfill和未清洗干净条件下Solder未充满Underfill两种情况下,建立有限元模型,基于Hypermesh强大的网格划分和编辑功能,分析了两种模型在热循环载荷下的应力,并计算了疲劳寿命。
一、模型的建立
由于结构的对称性,我们对结构的1/2建立模型。如图1所示为模型的结构示意图,模型中包含Chip、Substrate、Solder和underfill。焊球所用的材料为塑性材料,且其塑性与温度和应变率有关系。
![3)XOO7HPG%ILA(]BX76TH6P.png 基于Hypermesh的Flip-Chip封装工艺对电子器件的可靠性研究hypermesh应用技术图片1](http://www.1cae.com/i/g/55/554b42f01e30a6b55b48e96a86a03a81r.png)
二、网格的划分
图2所示为网格的划分示意图。本案例中,清洗干净条件下,节点个数为4525;未清洗干净条件下,中去除Solder四周边界的单元,网格节点个数为4447。
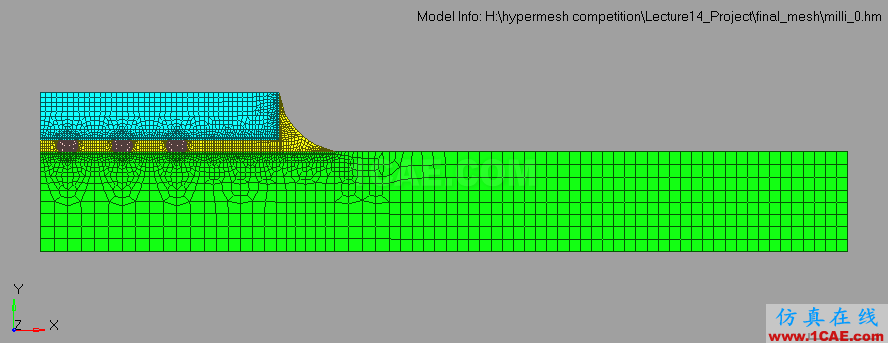

三、载荷施加
载荷为热循环载荷,加载分为5步。依次为:升温-保温-降温-保温-升温。温度循环曲线如下如所示。


四、结果分析
图4和图5分别为清洗干净条件下和未清洗干净条件下模型的位移场分布图,从中可以看出,模型的最大位移都为4.79×10-2μm,表明是否清洗干净对器件的变形基本没有影响。图6和图7分别为清洗干净条件下和未清洗干净条件下模型的等效塑性应变场分布图,从图中可以看出清洗干净条件下Soleder的最大等效塑性应变为3.47×10-2;而未清洗干净下,Soleder的最大等效塑性应变为4.15×10-2;可见相对于清洗干净条件下,未清洗条件下Solder的最大塑性应变较大。据此,我们可以利用著名的Coffin-Manson equation对器件的疲劳寿命进行计算。从中可以看出,相对于清洗干净条件下,未清洗干净条件下器件的疲劳寿命大大降低。在这种情况下,经计算得到solder的疲劳寿命约为清洗干净下的65%。可见,回流焊后Solder未清洗干净大大影响器件的可靠性。
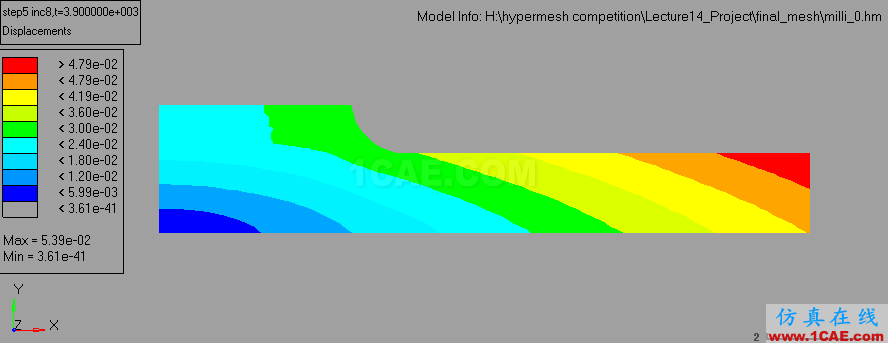


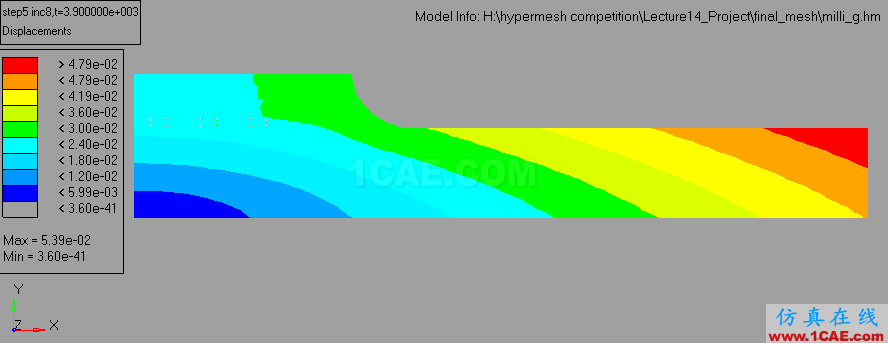

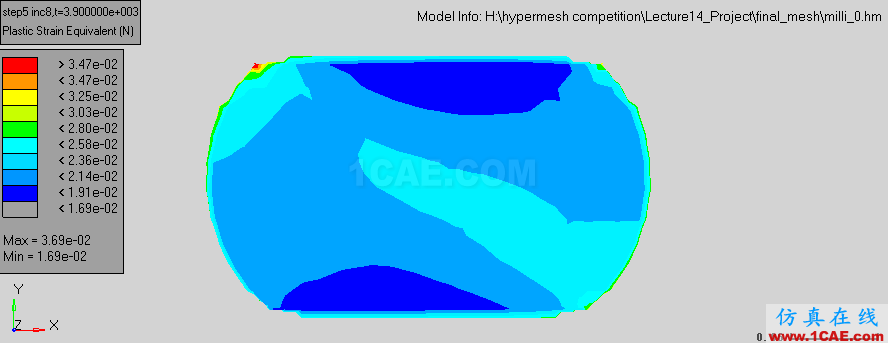
图6 清洗干净条件下Soleder的等效塑性应变
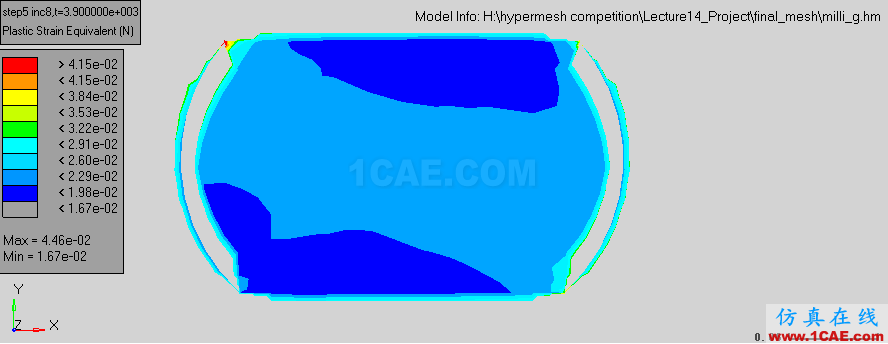

五、结论
本文对在Flip-Chip封装工艺中,对真空回流焊后Solder清洗干净条件下与未清洗干净条件下的器件建立了两种有限元分析模型,载荷为电子可靠性试验中的温度循环载荷。有限元分析结果表明,相对于清洗干净条件下,未清洗干净中Solder的最大塑性应变较大,同时寿命大大降低,电子器件的可靠性也大大降低。因此,Flip-Chip回流焊后的清洗工艺对器件的可靠性有很大的影响。在Flip-Chip封装工艺中,需要完善清洗工艺,确保Solder表面处无杂质,使underlfill充满Solder的周围。
相关标签搜索:基于Hypermesh的Flip-Chip封装工艺对电子器件的可靠性研究 HyperWorks有限元分析培训 HyperMesh网格划分培训 hyperMesh视频教程 HyperWorks学习教程 HyperWorks培训教程 HyperWorks资料下载 HyperMesh代做 HyperMesh基础知识 Fluent、CFX流体分析 HFSS电磁分析 Ansys培训 Abaqus培训






